
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
SiGe v proizvodnji čipov: strokovno novice
Razvoj polprevodniških materialov
Na področju sodobne polprevodniške tehnologije je neusmiljena težnja k miniaturizaciji premaknila meje tradicionalnih materialov na osnovi silicija. Da bi izpolnili zahteve po visoki zmogljivosti in nizki porabi energije, se je SiGe (silicijev germanij) pojavil kot izbrani kompozitni material pri proizvodnji polprevodniških čipov zaradi svojih edinstvenih fizikalnih in električnih lastnosti. Ta članek obravnavapostopek epitaksijeSiGe in njegova vloga pri epitaksialni rasti, napetih aplikacijah silicija in strukturah Gate-All-Around (GAA).
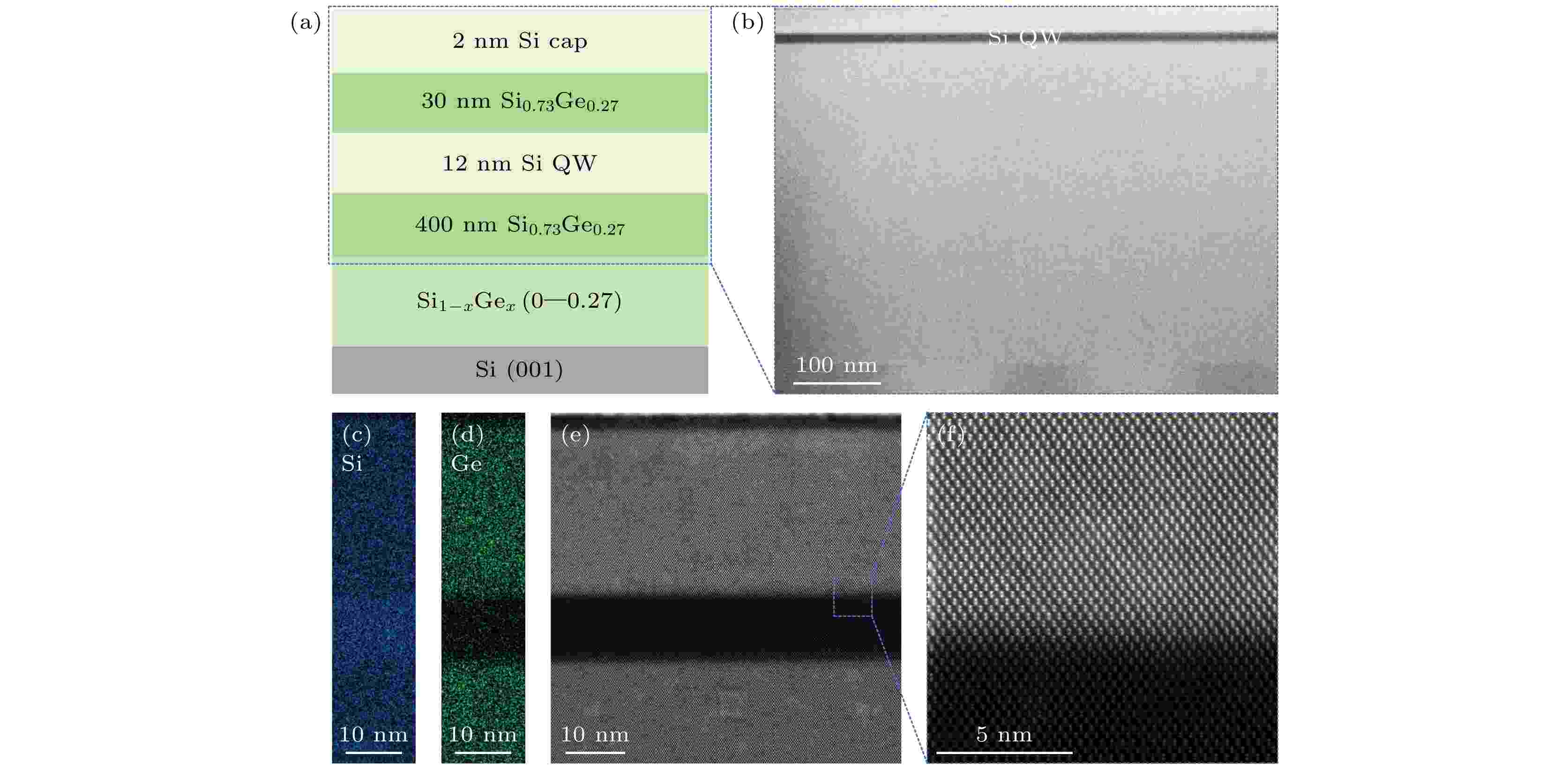
Pomen SiGe epitaksije
1.1 Uvod v epitaksijo v proizvodnji čipov:
Epitaksija, pogosto skrajšana kot Epi, se nanaša na rast enokristalne plasti na enokristalnem substratu z enako razporeditvijo rešetke. Ta plast je lahko bodisihomoepitaksialni (kot je Si/Si)ali heteroepitaksialne (kot je SiGe/Si ali SiC/Si). Za epitaksialno rast se uporabljajo različne metode, vključno z epitaksijo z molekularnim žarkom (MBE), kemičnim naparjevanjem v ultravisokem vakuumu (UHV/CVD), atmosfersko epitaksijo in epitaksijo pri znižanem tlaku (ATM & RP Epi). Ta članek se osredotoča na postopke epitaksije silicija (Si) in silicij-germanija (SiGe), ki se pogosto uporabljajo v proizvodnji polprevodniških integriranih vezij s silicijem kot substratnim materialom.
1.2 Prednosti epitaksije SiGe:
Vključitev določenega deleža germanija (Ge) medpostopek epitaksijetvori monokristalno plast SiGe, ki ne le zmanjša širino pasovne vrzeli, ampak tudi poveča mejno frekvenco tranzistorja (fT). Zaradi tega je v veliki meri uporaben v visokofrekvenčnih napravah za brezžične in optične komunikacije. Poleg tega v naprednih procesih integriranega vezja CMOS mrežna neusklajenost (približno 4 %) med Ge in Si povzroči mrežno napetost, poveča mobilnost elektronov ali lukenj in tako poveča tok nasičenja naprave in odzivno hitrost.
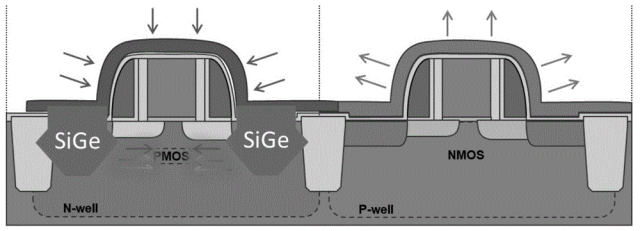
Obsežen tok postopka SiGe epitaksije
2.1 Predobdelava:
Silicijeve rezine so predhodno obdelane na podlagi želenih rezultatov postopka, predvsem z odstranitvijo naravnega oksidnega sloja in nečistoč na površini rezin. Pri močno dopiranih substratnih rezinah je ključnega pomena razmisliti, ali je za zmanjšanje samodejnega dopinga med nadaljnjimiepitaksija rasti.
2.2 Rastni plini in pogoji:
Silicijevi plini: Silan (SiH₄), diklorosilan (DCS, SiH₂Cl₂) in triklorosilan (TCS, SiHCl₃) so trije najpogosteje uporabljeni viri silicijevega plina. SiH₄ je primeren za nizkotemperaturne postopke popolne epitaksije, medtem ko se TCS, znan po svoji hitri rasti, pogosto uporablja za pripravo gostihsilicijeva epitaksijaplasti.
Plin germanij: German (GeH₄) je primarni vir za dodajanje germanija, ki se uporablja v povezavi z viri silicija za oblikovanje zlitin SiGe.
Selektivna epitaksija: Selektivna rast se doseže s prilagajanjem relativnih stopenjepitaksialno nanašanjein in situ jedkanje z uporabo silicijevega plina DCS, ki vsebuje klor. Selektivnost je posledica manjše adsorpcije atomov Cl na površini silicija kot pri oksidih ali nitridih, kar olajša epitaksialno rast. SiH₄, ki nima atomov Cl in ima nizko aktivacijsko energijo, se na splošno uporablja samo za postopke popolne epitaksije pri nizkih temperaturah. Drug pogosto uporabljen vir silicija, TCS, ima nizek parni tlak in je tekoč pri sobni temperaturi, zato je za vnos H₂ v reakcijsko komoro potrebno mehurčenje. Vendar pa je razmeroma poceni in se zaradi svoje hitre hitrosti rasti (do 5 μm/min) pogosto uporablja za gojenje debelejših silicijevih epitaksijskih plasti, ki se pogosto uporabljajo pri proizvodnji silicijevih epitaksijskih rezin.
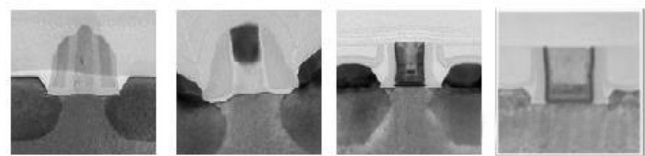
Napet silicij v epitaksialnih plasteh
Medepitaksialna rast, se epitaksialni monokristal Si nanese na sproščeno plast SiGe. Zaradi neusklajenosti mrežne mreže med Si in SiGe je monokristalna plast Si izpostavljena natezni napetosti iz spodnje plasti SiGe, kar znatno poveča mobilnost elektronov v tranzistorjih NMOS. Ta tehnologija ne samo poveča tok nasičenja (Idsat), ampak tudi izboljša hitrost odziva naprave. Pri napravah PMOS se plasti SiGe po jedkanju epitaksialno gojijo v izvornih in odvodnih območjih, da se na kanal uvede tlačna napetost, poveča mobilnost lukenj in poveča tok nasičenja.
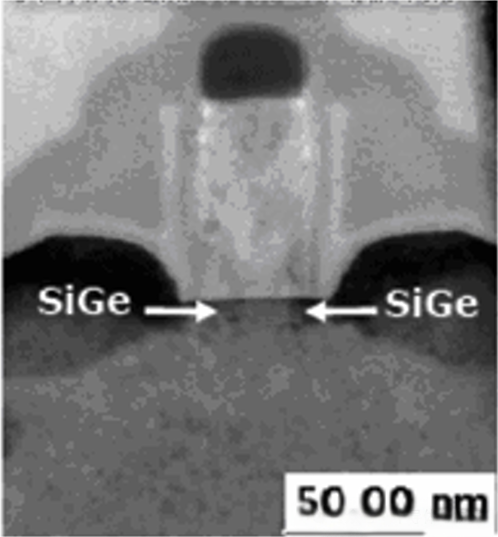
SiGe kot žrtvena plast v strukturah GAA
Pri izdelavi nanožičnih tranzistorjev Gate-All-Around (GAA) plasti SiGe delujejo kot žrtvene plasti. Visoko selektivne tehnike anizotropnega jedkanja, kot je kvazi-atomsko plastno jedkanje (kvazi-ALE), omogočajo natančno odstranitev plasti SiGe za oblikovanje nanožičnih ali nanolistnih struktur.
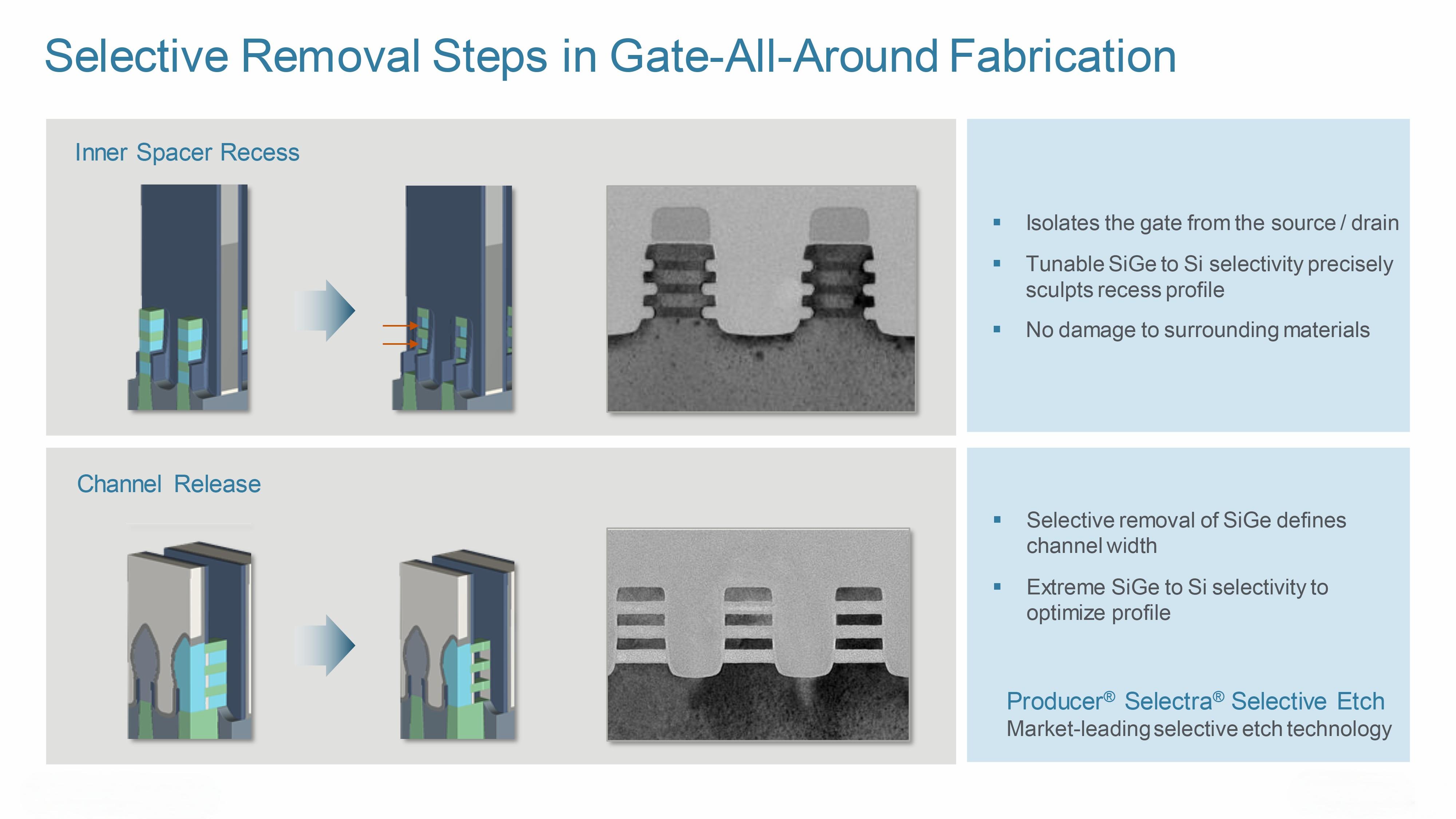
V podjetju Semicorex smo specializirani zaSiC/TaC prevlečene grafitne raztopineuporablja pri Si epitaksialni rasti v proizvodnji polprevodnikov, če imate kakršna koli vprašanja ali potrebujete dodatne podrobnosti, ne oklevajte in stopite v stik z nami.
Kontaktni telefon: +86-13567891907
E-pošta: sales@semicorex.com




